Forskare vid Okinawa Institute of Science and Technology (OIST) har presenterat en lösning för litografiutrustning med EUV-strålning (extreme ultraviolet) som drar endast en tiondel av den energi som dagens kommersiella lösningar från nederländska ASML. Förutom att dra betydligt mindre energi i drift är konceptet också tänkt att vara betydligt billigare att tillverka och driftsätta, enligt professor Tsumoru Shintake vid OIST.
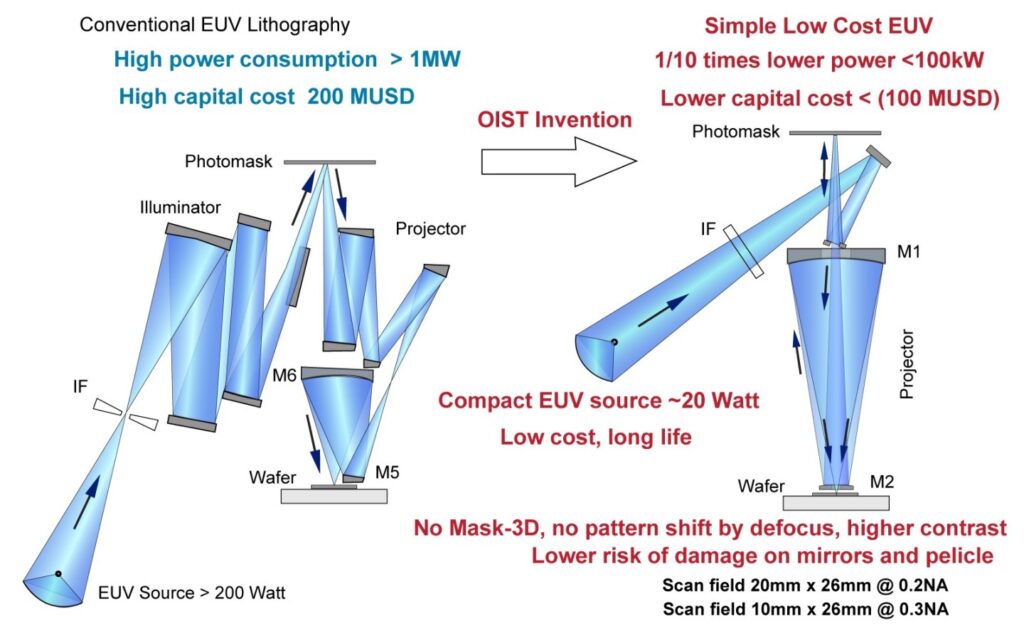
Vid en första anblick är OIST:s lösning förbluffande enkel – i praktiken rationaliseras större delen av de speglar som används av EUV-scanners bort, för att istället nyttja totalt fyra speglar, varav två axisymmetriska i linje med kiselskivan. Det ska bana väg för effektiv produktion av halvledare med hjälp av en EUV-ljuskälla med en uteffekt så liten som 20 watt, att ställa mot ASML:s 200 watt.
OIST menar att den totala energiförbrukningen med universitetets EUV-lösning skulle sjunka från ”uppemot en megawatt” (1 000 kilowatt) till så lite som 100 kilowatt under drift. I och med lägre effekter ska risken för skador på speglar och membran (pellicles) vara betydligt lägre, medan andra viktiga parametrar som pattern shift minimeras och kontrast rentav höjs jämfört med existerande EUV-scanners.
This configuration is unimaginably simple, given that conventional projectors require at least six reflective mirrors. This was made possible by carefully rethinking the aberration correction theory of optics. It is a triumph of classical physics before quantum physics
– Professor Tsumoru Shintake, OIST
Professor Shintake kallar själv lösningen ”otänkbart enkel” i jämförelse med ASML:s kommersiella lösningar, som han noterar kräver ”minst sex speglar”. Att minimera antalet speglar är av största vikt för att maximera verkningsgraden, då 40 procent av EUV-energin går förlorad vid varje reflektion. Enligt OIST kvarstår endast 1 procent av energin som skapas efter att ha reflekterats i de tio speglar en kommersiell EUV-scanner innehåller.
Genom att minska det totala antalet speglar till endast fyra stycken kvarstår med andra ord drygt 10 procent av den strålning som skapats vid källan – över 2 watt med en 20-wattskälla. Detta är direkt jämförbart med energin som projiceras på en kiselskiva i en EUV-scanner från ASML, medan OIST:s lösning i nuläget hyser en maximal kretsstorlek (scan field) om 20 × 26 millimeter (520 mm2) vid 0,2 NA eller 10 × 26 mm (260 mm2) vid 0,3 NA. Detta är att jämföra med ASML:s EUV-scanners som är kapabla till ”fullstora” kretsar om 33 × 26 mm (858 mm2) vid 0,33 NA, eller bolagets High NA-utrustning som brukar anamorfiska speglar för kretsstorlekar upp till 16,5 × 26 mm (429 mm2).
OIST har ansökt om patent på sin EUV-lösning och hoppas demonstrera den i praktiken under de kommande åren. Tekniken står sannolikt i topp på Kinas önskelista, då litografiutrustning är landets största bristvara på väg mot självförsörjning inom halvledarproduktion – men andra intressenter lär inkludera de japanska tillverkarna av litografiutrustning Canon och Nikon.





