Powertech, Taiwans näst största bolag för paketering och test, OSAT (outsourced semiconductor assembly and test), uppges åtnjuta rekordstor efterfrågan till följd av AI-boomen och lanseringen av bolagets avancerade paketeringsteknik Pillar Integration Fan Out (PiFO) – en utmanare till TSMC:s CoWoS-L. Enligt Economic Daily News har Powertech knipit stora ordrar från ”ett flertal stora amerikanska AI-bolag”, där majoriteten av bolagets kapacitet för 2026 redan är slutsåld.
Paketering hos TSMC enligt CoWoS har haft fördelen att kunder kunnat beställa allting från en och samma leverantör, där TSMC förutom att vara störst i världen på produktion av kretsar också är störst på avancerad paketering. Bolagets kapacitet har trots detta inte varit tillräcklig, vilket nu spiller över på aktörer likt Powertech – vars PiFO inte bara är 30 procent billigare än TSMC:s CoWoS-L, utan också görs på fyrkantiga glassubstrat med bättre värmeavledning än traditionella lösningar.
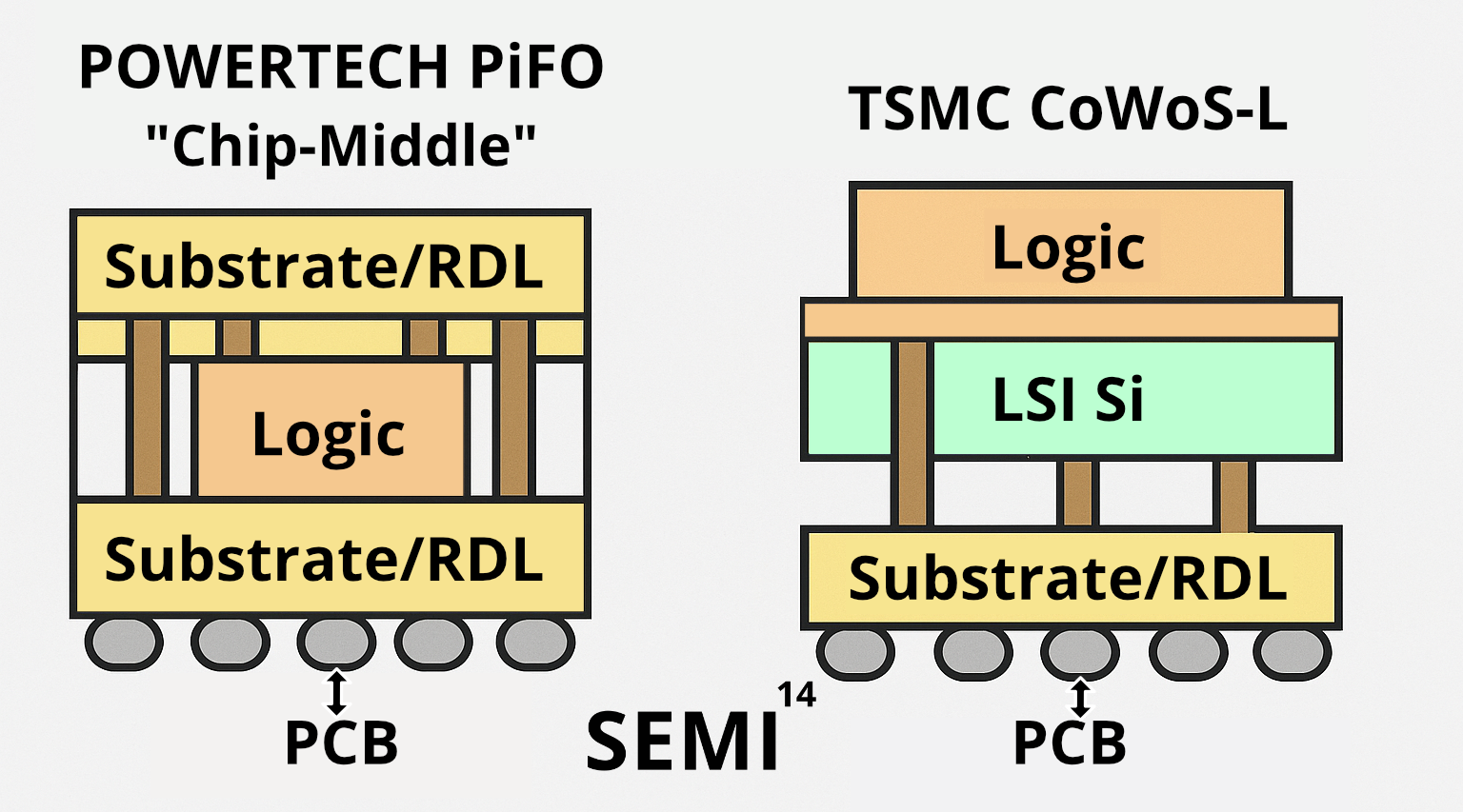
I korthet placerar PiFO själva beräkningskretsen i mitten av paketet, något bolaget själv logiskt nog kallar ”chip middle”. En färdigpaketerad produkt enligt PiFO levereras med den ursprungliga kretsen mellan två substrat som hålls samman av kopparpelare, därav ”Pillar Integration”. Detta erbjuder mer utrymme för kopparbanor, RDL (redistribution layer), och är sannolikt en av anledningarna till Powertechs kostnadsfördelar jämte TSMC då den senare i CoWoS-L kör delar av signalhanteringen i dedikerade kiselkretsar, LSI (local silicon interconnect).
Som ett ytterligare tecken på att Powertech har vind i seglen väntas bolaget investera rekordsumman 40 miljarder taiwanesiska dollar (TWD), motsvarande cirka 12,3 miljarder kronor, i utbyggnad av sina faciliteter under 2026. Detta är kapitalinvesteringar som är dubbelt upp från 2025 års nivåer, och görs givetvis i syfte att kunna rida på vågen globala investeringar i AI-hårdvara utöver de åtaganden bolaget har gentemot sina traditionella kunder i minnessektorn.
Inte heller TSMC vilar sig i form på paketeringsfronten, trots att bolaget formligen trycker pengar genom att dominera produktionen av världens mest avancerade pengar. Sedan tidigare har bolaget tidigarelagt anläggningar för avancerad paketering enligt CoWoS i USA, där produktion inleds år 2028. Desto fortare går det för bolaget på hemmaplan, där inte mindre än tolv nya anläggningar för avancerad paketering kan tillkomma under 2026, enligt Trendforce.
TSMC å sin sida har indikerat att dess kapitalutgifter för 2026 väntas nå 40–42 miljarder USD, eller cirka 380–400 miljarder kronor. Av dessa är cirka 70 procent öronmärkta för produktion av avancerad logik, 10–20 procent för ”specialiserad teknologi” med resterande 10–20 procent för avancerad paketering och test. Totalt väntas alltså TSMC under 2026 investera motsvarande 40–80 miljarder kronor i utbyggnad av CoWoS-paketering – drygt tre till närmare sju gånger så mycket som Powertech.