Det belgiska halvledarforskningsinstitutet Imec kommer under veckan visa upp kiselstrukturer med 20 nanometer metal pitch, framställda med en enkel litografiexponering. Framstegen har nåtts med ASML:s EUV-scanners av High-NA-typ och kommer publikt demonstreras under konferensen SPIE Advanced Lithography + Patterning i San Francisco.
Den metal pitch om 20 nanometer som Imec uppger sig kunna framställa med en yield över 90 procent motsvarar strukturer i framtidens tillverkningstekniker ”under 2 nanometer”, enligt Imec. Som exempel har TSMC:s mest 3-nanometersteknik med högdensitetsbibliotek en metal pitch så liten som 23 nanometer – något som uppnås med hjälp av flera EUV-litografiska exponeringar (eng. multi-patterning).
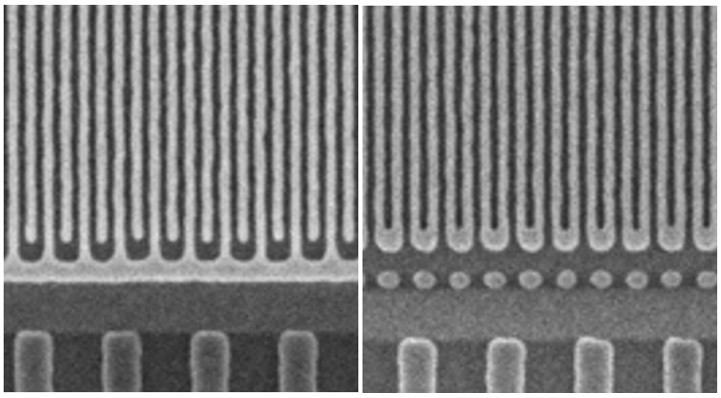
Imec låter också hälsa att strukturer av både typerna meanders och forks har framställts i en aktiv jakt på stokastiska defekter. Just stokastiska defekter var fram till halvledarbranschens kliv till avancerad DUV-litografi något som praktiskt taget sveptes under mattan, men har blivit ett av EUV-teknikens största problem.
Att just EUV är speciellt utsatt beror på att strukturerna som framställs dels är mindre än någonsin förut, men också på grund av att EUV-ljuset har tvingat fram nya lösningar för kritiska kemikomponenter som fotoresist. Dessa har praktiskt taget inte haft tillräcklig utvecklingstid på sig för att kunna närma sig felfriheten som fotoresist för DUV – och Imec menar att dess enkelexponerade High-NA EUV-process visar på ett ”lågt antal” av dessa defekter vid elektriskt test.
These insights support our ecosystem partners in the development of strategies to mitigate stochastic defects. One of our ongoing efforts is focused on optimizing resist performance in terms of dose-to-yield reduction with minimal impact on stochastic failures, an effort we are making in close collaboration with the resist community.
– Philippe Leray, Director of Advanced Patterning, Imec
Institutets Philippe Leray talar föga förvånande om framtiden, där han sätter fingret på hur de nya insikterna i praktiken tjänar till att minska de stokastiska defekterna med High-NA EUV. Specifikt pekar han också ut fotoresister som ett område där framsteg görs för att minska defekter – något som lär vara ett krav innan bolag som TSMC och Intel vågar sig på massproduktion av kretsar i 2-nanometersklassen och mindre utan att förlita sig på multi-patterning.
Nämnvärt i sammanhanget är att även Lundabolaget Alixlabs kommer ta plats under SPIE-konferensen i San Franscisco senare i veckan. Alixlabs kommer å sin sida demonstrera sin etsteknik som producerat kiselstrukturer med en metal pitch om 25 nanometer – utan någon som helst EUV-litografi.